根本原因:BGA原材料有原始微裂纹,PCB在焊接过程中翘曲变形,使裂纹扩展,导致开裂。
改进建议:
1. 焊接过程中控制BGA的翘曲。2. 严格控制BGA来料质量。

PCB表面处理是化镍浸金。
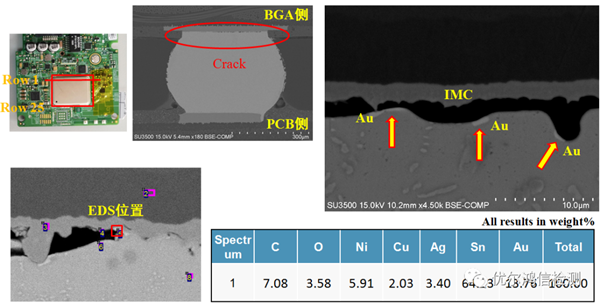
此外,断裂区还发现金元素富集,应排除“金脆”现象。
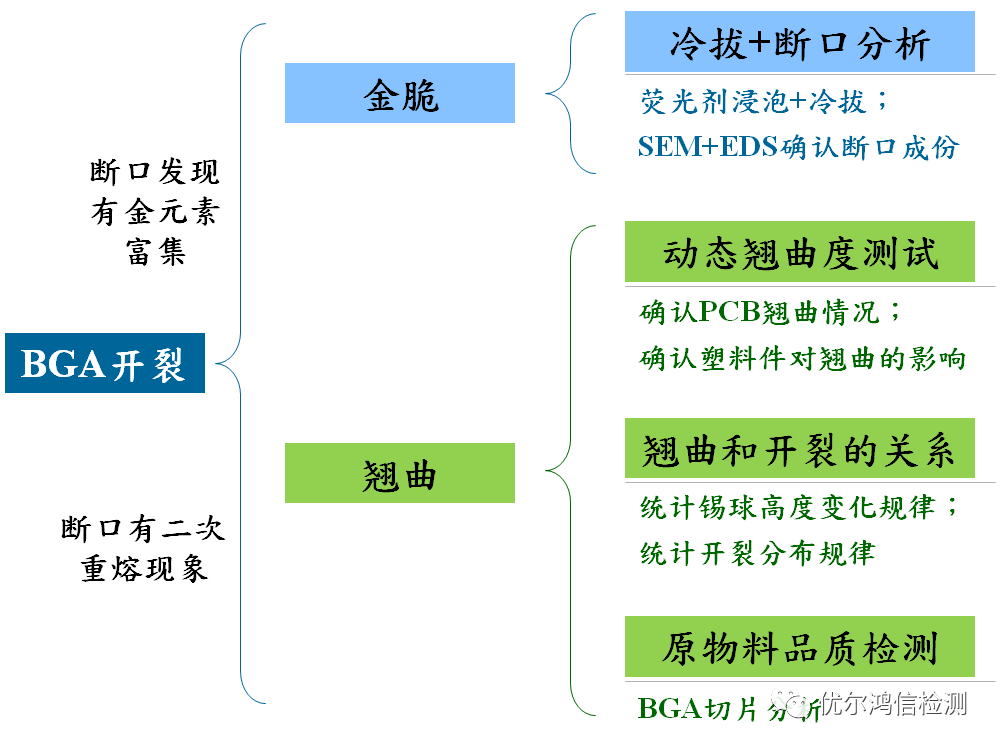
将主板浸入3%荧光剂溶液中,抽真空,干燥,并在BGA位置上冷拉。观察焊点在紫外光照射下的发光情况,以确认开裂情况。

焊点开裂区未发现明显的Au元素富集,排除了“金脆”引起BGA开裂的可能性。
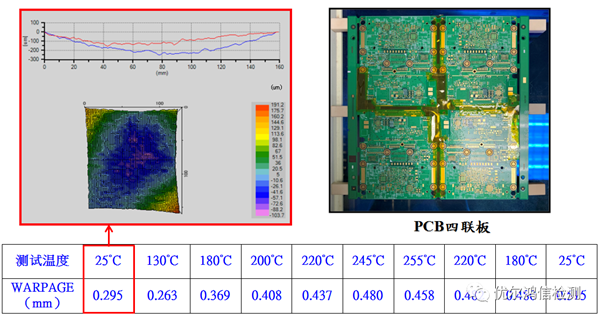
对PCB四板进行了动态翘曲试验,结果如上图所示。PCB在室温下即有一定的变形,中间有凹面,左上角和右下角有一定凸面。

PCB四重板在加热过程中会逐渐软化变形,呈现中间凹陷,两边凸起的形式,直到冷却结束,这种形式也没有明显变化。在最后冷却到室温时,翘曲出现极值。因此,在第一炉后,PCB冷却后会有最大的翘曲。

对仅有B面的小板进行了动态翘曲试验,结果如上图所示。未发现明显翘曲。个别的小板翘曲并不严重,并且小板上的塑料部件不会加剧PCB翘曲。

在BGA焊球的左侧,裂纹更多地出现在左侧。右侧锡球,右侧多出现裂缝。与翘曲有一定的相关性。
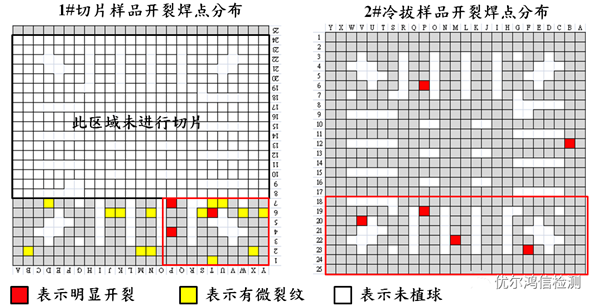
对不良BGA焊球的裂纹状况进行了统计分析。结果表明,焊点裂纹多发生在未植球的空白区域附近,部分区域(红框位置)裂纹较为严重。
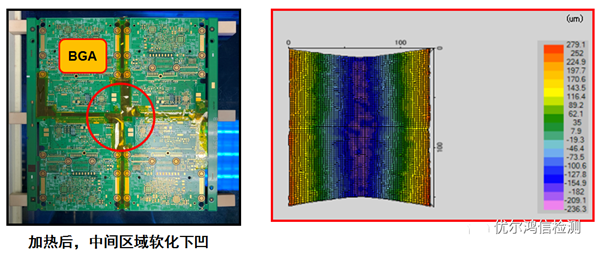
综上所述,BGA焊球越靠近PCB的中间区域,就越容易开裂。
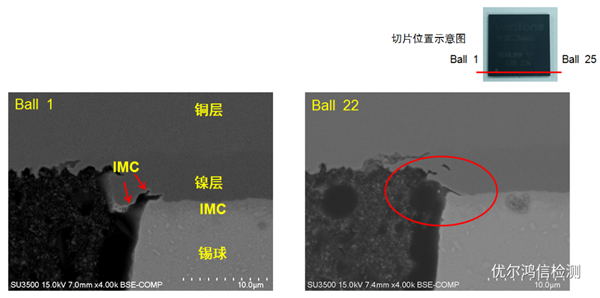
结果发现,1pcs BGA原材料的角部部分锡球存在小间隙或微裂纹。在第一排25个焊锡球中的三个发现了微裂纹或小缺口。 在小切口区域内,内模控制的形成可能与球的边缘去湿有关。
综上所述,推测具有原始微裂纹的焊球在焊接过程中会对PCB板产生翘曲变形,使裂纹扩展,导致焊球开裂。
结论1. BGA裂纹发生在模块侧面的IMC层,断口进行了两次重熔。断裂带内存在金元素富集现象。
2. 排除了“金脆”引起BGA开裂的可能性。
3. 动态翘曲测试结果表明,PCB板在加热过程中变形明显,呈现中间凹陷、左右两侧凸起的形状。冷却后翘曲最严重(255°C至25°C)。
4. 裂纹焊点的统计结果表明,裂纹多发生在未植球的空白区域附近,部分区域焊点裂纹较为严重,与翘曲有一定的相关性。根据测试结果,BGA焊球越靠近PCB的中间区域,越容易开裂。
5. 原材料切片后,在锡球中发现了原始的微裂纹。据推测,焊球中原有的微裂纹在焊接过程中,PCB板翘曲变形,使得裂纹扩展,导致焊球开裂。
改进建议1. 在焊接过程中控制PCB的翘曲。
2. 严格控制BGA来料质量。
推荐阅读:
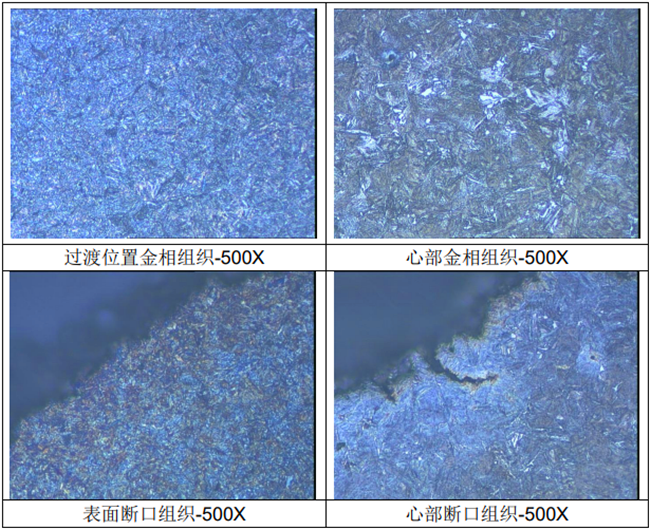 【失效分析】差速器疲劳测试时开裂
2024-02-03
【失效分析】差速器疲劳测试时开裂
2024-02-03
 2024 年第二十届能力验证活动邀请函
2024-01-27
2024 年第二十届能力验证活动邀请函
2024-01-27
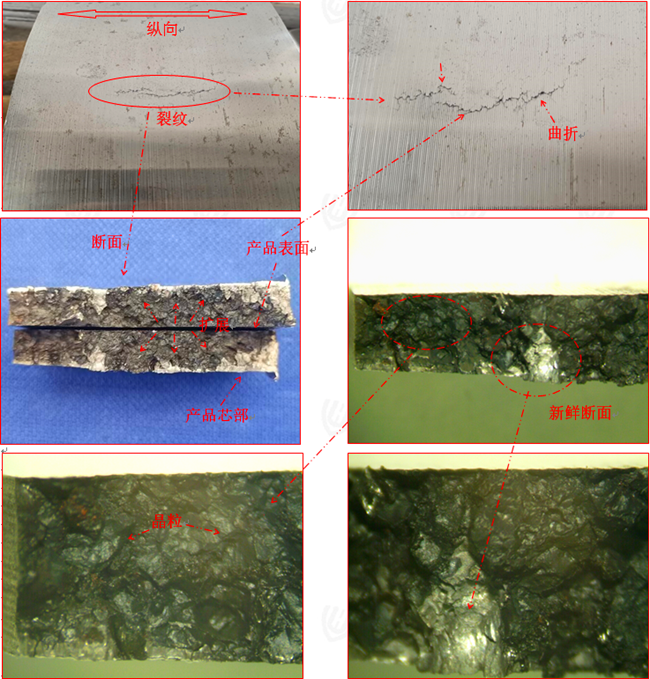 【失效分析】梅花头失效分析案例
2024-01-25
【失效分析】梅花头失效分析案例
2024-01-25
 S136模仁注塑开裂分析
2023-11-05
S136模仁注塑开裂分析
2023-11-05
 【失效分析】铝材表面湿度处理后脏污不良分析
2023-10-16
【失效分析】铝材表面湿度处理后脏污不良分析
2023-10-16
 形位公差及检测设备介绍
2023-10-14
形位公差及检测设备介绍
2023-10-14