一、失效背景调查
公司內部某单位所使用的U73Z002.00 PCB回流焊後發現U1 BGA出現大型空洞(area> 25%)。对该位置进行切片以确认不良现象,结果如下图所示:
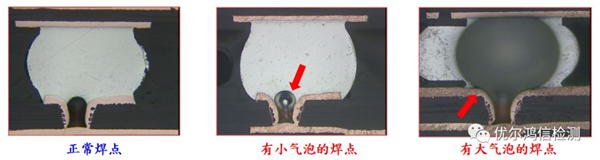
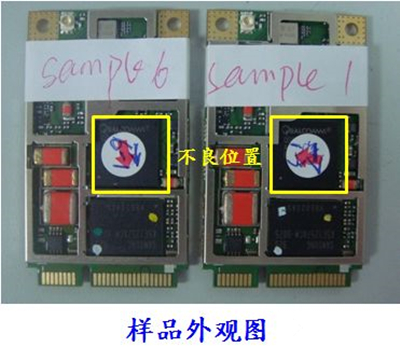
助焊剂中有机溶剂挥发:Flux中有机溶剂在焊接高温中挥发产生气体。PCB焊盘盲孔
残留空气锡膏印刷时,锡膏覆盖在盲孔上使孔内空气难以逃溢;回流焊时,内部空气受热膨胀,形成上圆下尖形状的空洞。
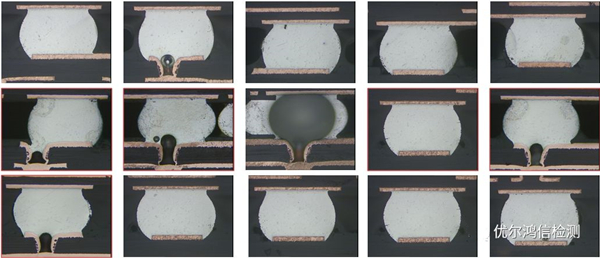

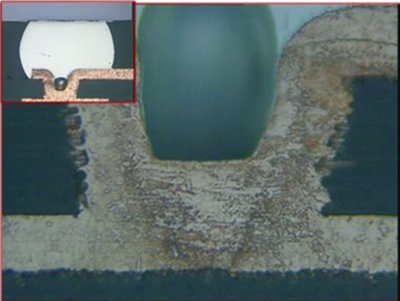
无大气泡的盲孔结构焊球(范例)
盲孔底部角度平滑,孔壁完整无Crack,不易积存水汽。

出现大气泡的盲孔结构焊球
盲孔底部凹坑,易积存水汽液体。
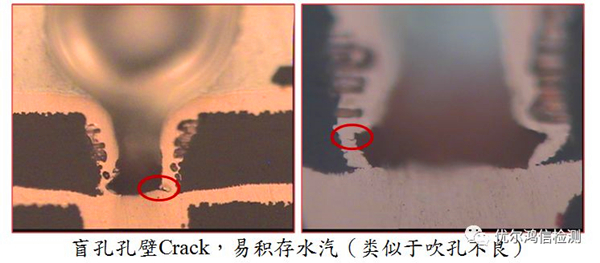



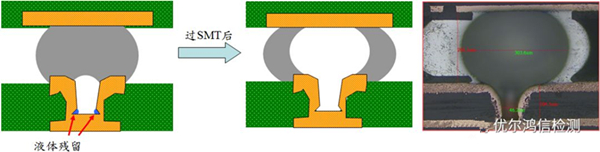

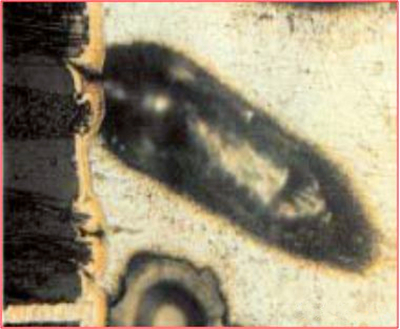
焊接时,孔壁上的破孔向外吹气称为吹孔。

这些气体会沿着孔壁的吹孔排放到焊锡中,加剧了大气泡的生成。
相关阅读:
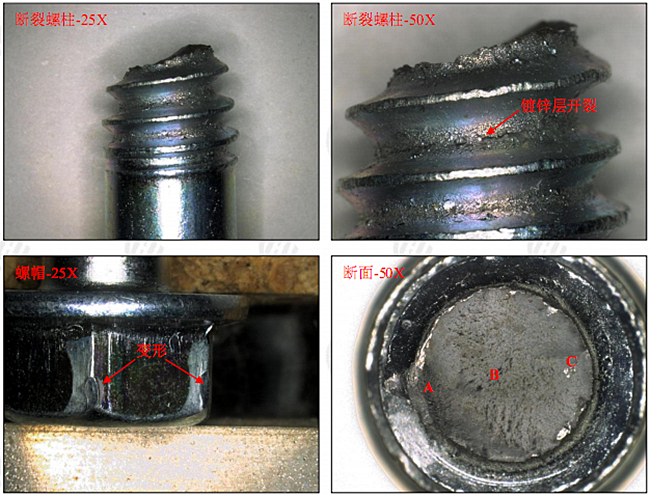 【失效分析】螺栓装配过程中断裂失效
2024-04-11
【失效分析】螺栓装配过程中断裂失效
2024-04-11
 【失效分析】双头螺栓断裂失效分析
2024-03-27
【失效分析】双头螺栓断裂失效分析
2024-03-27
 【失效分析】螺杆断裂失效
2024-03-21
【失效分析】螺杆断裂失效
2024-03-21
 【失效分析】汽车驱动轴断裂
2024-03-02
【失效分析】汽车驱动轴断裂
2024-03-02
 【失效分析】差速器螺栓失效分析
2024-02-22
【失效分析】差速器螺栓失效分析
2024-02-22
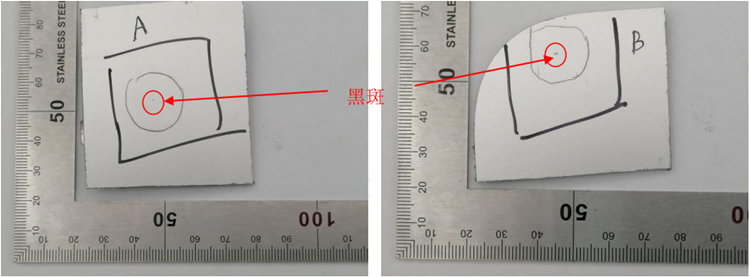 【失效分析】铝合金框架阳极黑斑
2024-02-19
【失效分析】铝合金框架阳极黑斑
2024-02-19