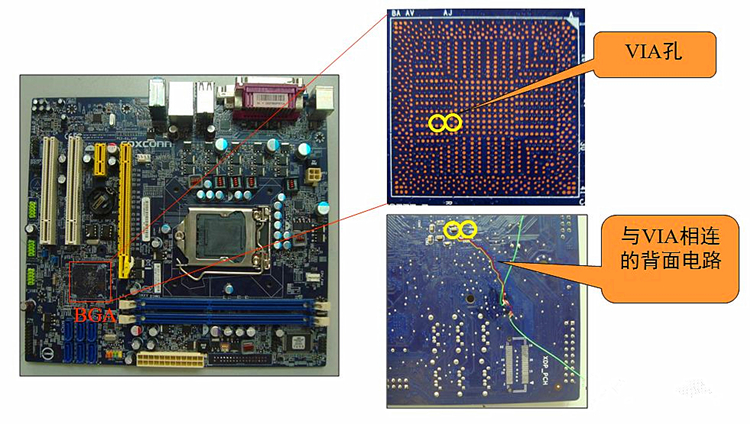


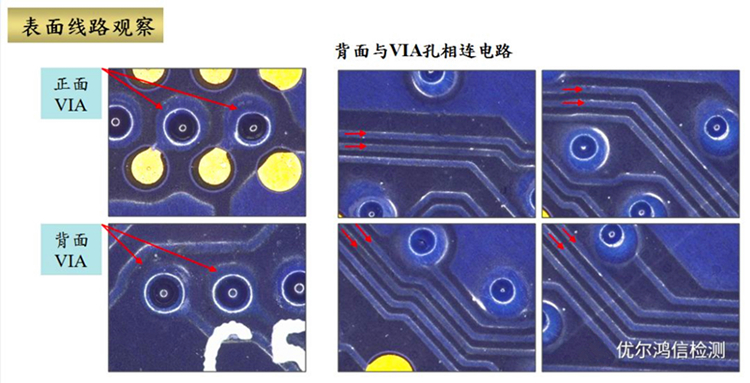


Conductive Anodic Filament对失效样品进行CAF测试。测试条件:85℃,85%RH;施加直流电压100V。

Sample
SIR Result (Ω)
0h
12h
24h
48h
96h
98h
1#
1.78E+0.7
/
/
/
/
/
问题区域不到两小时阻值就低于106Ω,被系统判定为失败。
实验验证—确认漏电流位置
用锯片将VIA孔与背面相联的电路分开,并单独对背面电路进行绝缘阻抗测试。
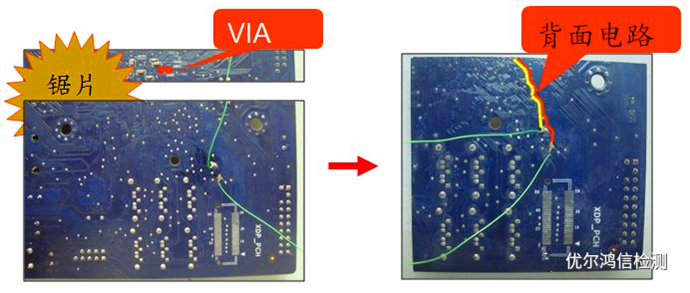

在85℃,85%RH;施加直流电压100V条件下,对背面电路进行绝缘阻抗测试。
Sample
SIR Result (Ω)
0h
12h
24h
48h
96h
98h
1#
3.33E+11
4.37E+0.9
4.95+0.9
6.29E+0.9
4.90E+0.9
4.39E+0.9
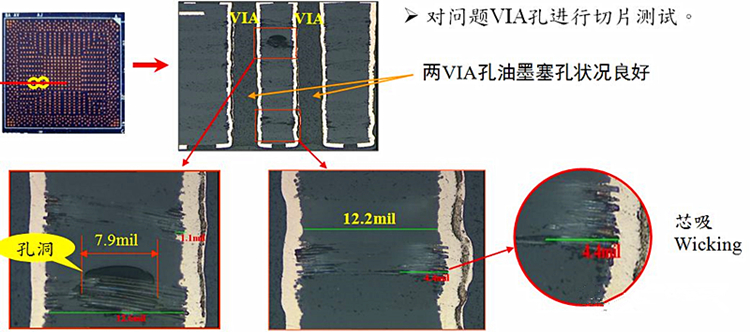
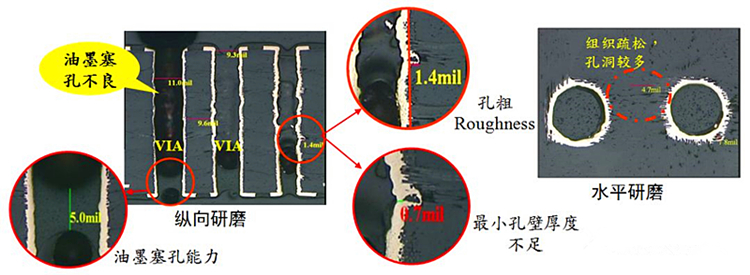
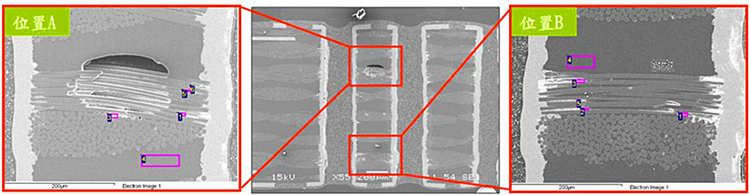
位置A
C
O
Al
Si
Ca
Fe
Cu
Total
1
/
49.07
10.87
26.25
13.82
/
/
100.00
3
45.59
31.95
6.13
9.71
6.02
/
0.59
100.00
4
64.16
20.94
14.90
/
/
/
/
100.00
5
3.71
45.61
9.25
24.13
14.68
1.57
1.05
100.00
6
11.28
42.29
18.90
17.28
7.55
/
2.70
100.00
位置B
C
O
Al
Si
K
Ca
Cu
Total
1
17.38
40.18
6.68
22.77
/
12.99
/
100.00
2
8.87
46.62
19.36
16.46
/
8.69
/
100.00
3
35.07
34.51
8.62
13.40
/
7.35
1.04
100.00
4
63.88
21.18
14.95
/
/
/
/
100.00
5
5.50
47.98
9.93
23.11
0.40
13.07
/
100.00
↓SEM+EDS分析图表↓
实验验证—SEM+EDS分析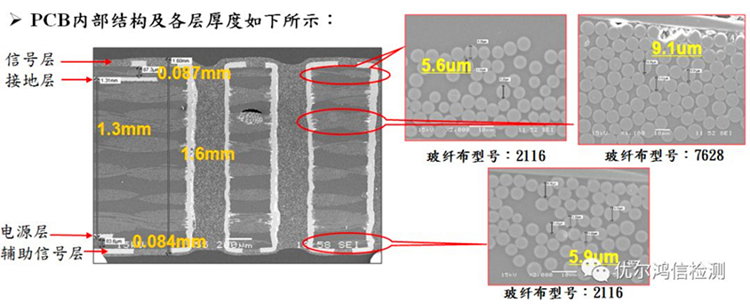
常用PCB基材型号及规格
规格
布厚(英寸)
布组织(股数/英寸)
玻璃纱规格
经
纬
经
纬
1080
0.0022
60
47
ECD450
ECD450
2116
0.0040
60
58
ECD235
ECD225
7628
0.0069
44
32
ECG 75
ECG 75
备注:E表示E-GLASS,C表示连续式的玻纤丝,D表示直径5μm,G为直径9μm,最后的数值表示一股纱其重量一磅时的长度(单位为百英尺)。1080与2116玻纤丝直径约5μm,7628玻纤丝直径约9μm。
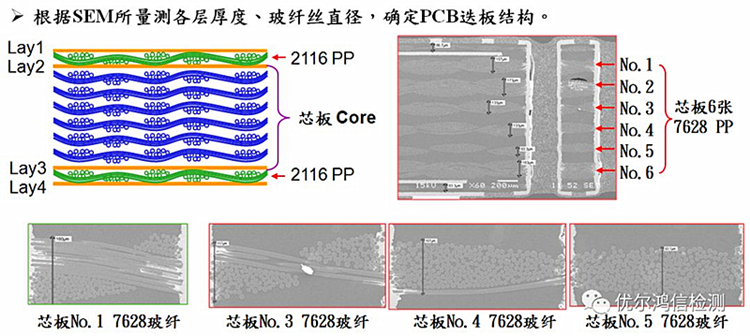
上述CAF产生条件中,水气、电解质、偏压难以避免,“迁移的通道”则为管控重点。可通过玻纤布良好的胶体填充以及合理的钻孔参数得以避免。
常用PCB基材(半固化片)类型及其参数
型号
1080LG
2116LG
7628LG
7628SP
7628U
树脂含量(%)
62±3
50±3
43±3
47±3
50±3
树脂流量(%)
35±5
25±5
22±5
25±5
32±5
凝胶时间(%)
130±20
挥发份含量(%)
≤0.5
玻璃态转化温度(℃)
>125
理论厚度(mil)
2.95
4.3
6.9
7.5
9.0


推荐阅读:
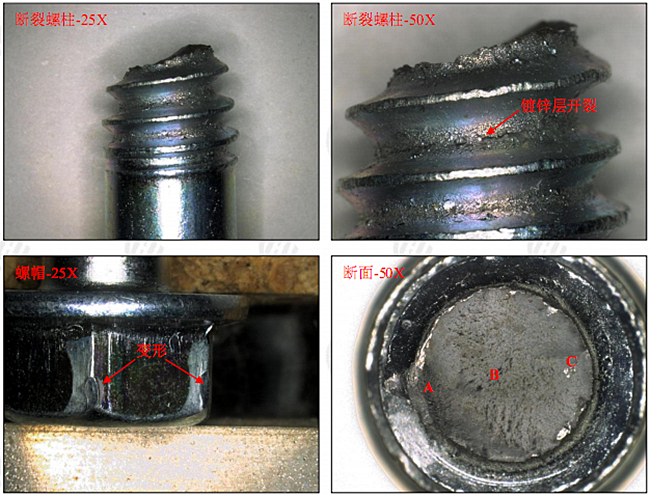 【失效分析】螺栓装配过程中断裂失效
2024-04-11
【失效分析】螺栓装配过程中断裂失效
2024-04-11
 【失效分析】双头螺栓断裂失效分析
2024-03-27
【失效分析】双头螺栓断裂失效分析
2024-03-27
 【失效分析】螺杆断裂失效
2024-03-21
【失效分析】螺杆断裂失效
2024-03-21
 【失效分析】汽车驱动轴断裂
2024-03-02
【失效分析】汽车驱动轴断裂
2024-03-02
 【失效分析】差速器螺栓失效分析
2024-02-22
【失效分析】差速器螺栓失效分析
2024-02-22
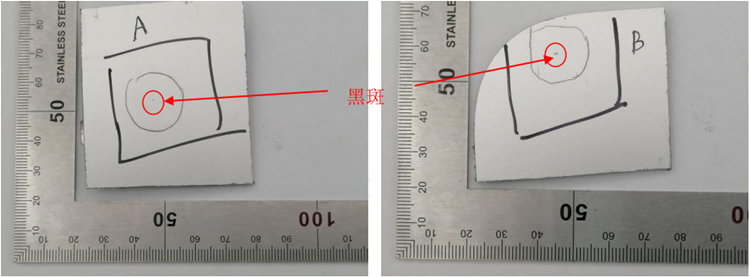 【失效分析】铝合金框架阳极黑斑
2024-02-19
【失效分析】铝合金框架阳极黑斑
2024-02-19