依照客户提供的失效信息,与客户讨论后给出的最终方案如下表。
1.零件本体是否有损伤
2.器件表面丝印核对
NO
检测项目
目的
设备
1
外观检测
3D显微镜
2
电性量测(IV曲线)
通过IV曲线确定产品功能问题
特性曲线仪
3
化学开封
内部芯片是否损伤
激光开封机+化学开封
4
OBIRCH测试
内部芯片损伤位置定位
OBIRCH侦测仪
3.1 外观检查
产品整体结构正常,正表面丝印清晰可识别,背面焊盘有焊锡残留,没有发现有机械裂痕及烧伤痕迹。
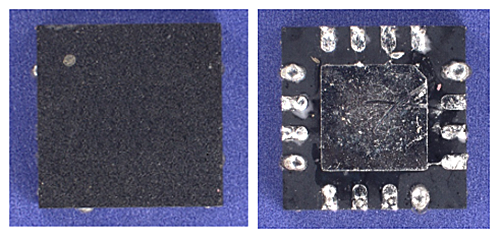
3.2 IV量测
依照产品Pin脚结构图(如下图),对产品所有功能Pin进行IV信号量测,并与良品进行比对,其中发现RF2功能pin对地漏电明显。

产品Pin脚结构图
3.3 开封测试对失效样品通过激光打磨及化学腐蚀,观察内部晶圆,绑线保留完整,晶圆表面未发现异常。
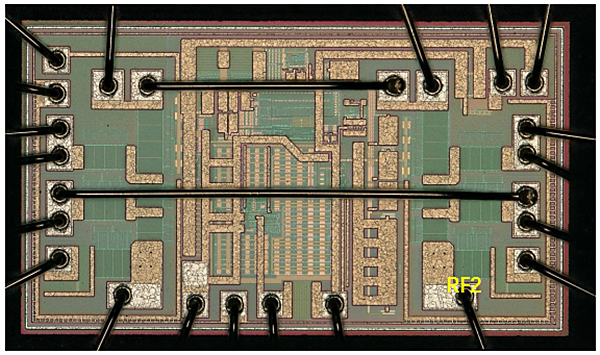
通过OBIRCH(镭射光束诱发阻抗值变化测试)测试手段,对漏电异常RF2脚进行追踪,在晶圆表面呈现异常热点。
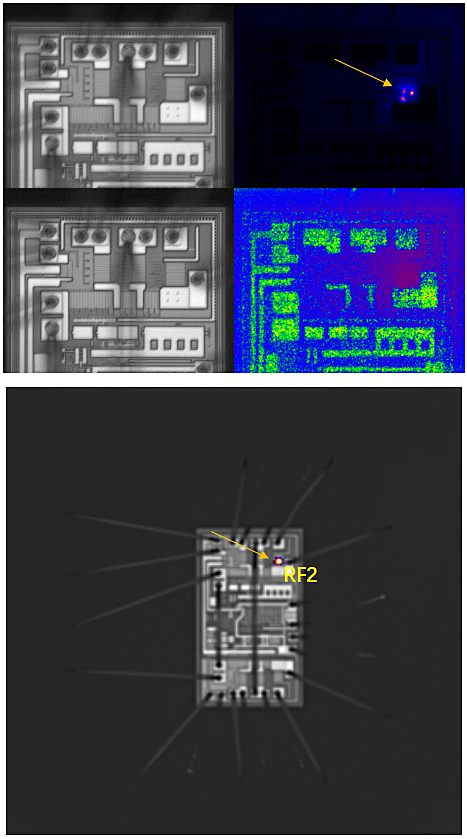
四、结论
样品编号
结果
外观检测
样品表面未发现损伤
IV量测
与良品比对,失效样品1#“RF2-GND”IV 曲线明显有差异
开封测试
失效样品 1#芯片表面未发现有异常
OBIRCH测试
发现异常热点
综合以上测试结果:考虑失效原因是ESD损伤。
推荐阅读:

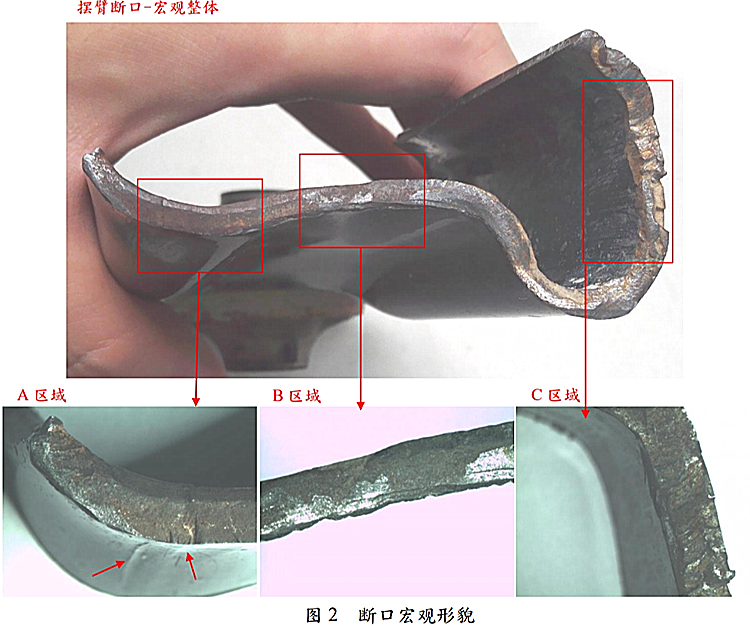 【失效分析】汽车摆臂断裂分析
2024-10-29
【失效分析】汽车摆臂断裂分析
2024-10-29
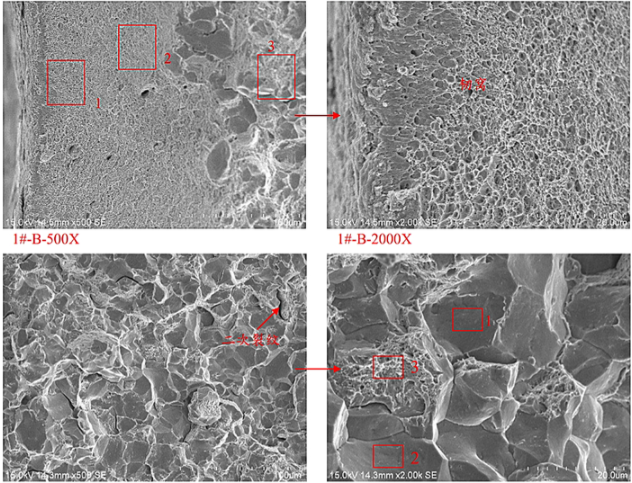 【失效分析】汽车齿轮卡圈断裂分析
2024-10-26
【失效分析】汽车齿轮卡圈断裂分析
2024-10-26
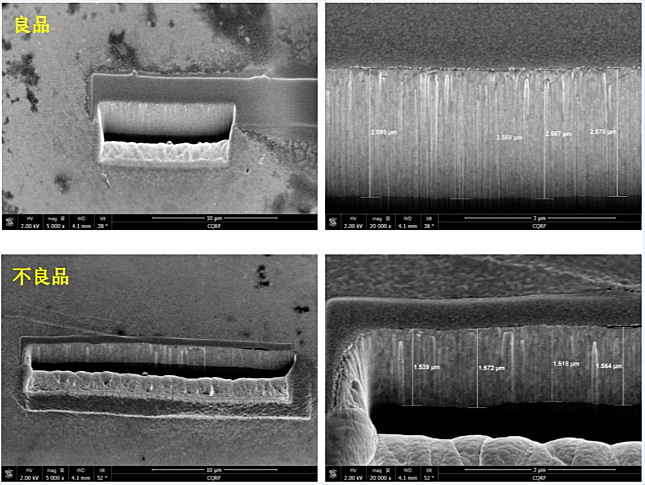 FPC钢片接地电阻偏高不良分析
2024-09-25
FPC钢片接地电阻偏高不良分析
2024-09-25
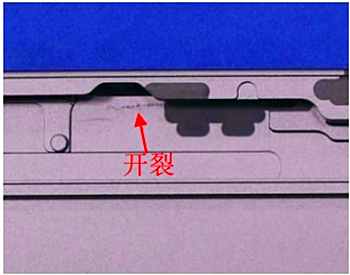 【失效分析】铝合金外壳开裂不良分析
2024-09-04
【失效分析】铝合金外壳开裂不良分析
2024-09-04
 【失效分析】汽车仪表盘闪烁
2024-08-24
【失效分析】汽车仪表盘闪烁
2024-08-24
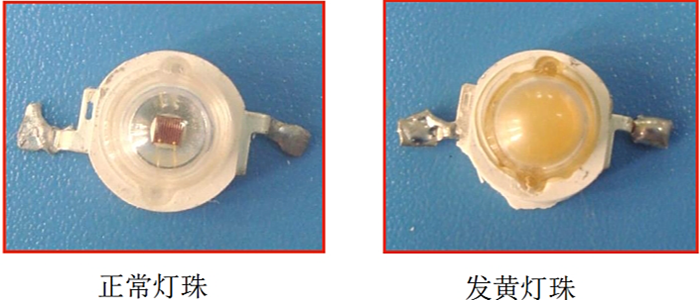 【失效分析】白光LED路灯发黄
2024-07-13
【失效分析】白光LED路灯发黄
2024-07-13