客户生产的主板进行ICT测试存在异常,进一步发现内部IC芯片存在微短路现象,并反馈“测试电流稍大,短路会消失;甚至万用表量测,短路也可能会消失”。现送不良品进行失效分析,以期找出失效原因。

3.1 X-Ray检测
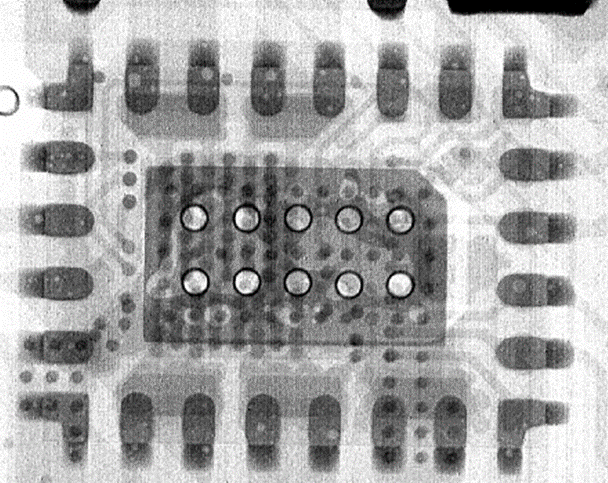
3.2 LIT热点侦测分析

3.3 CT无损检测
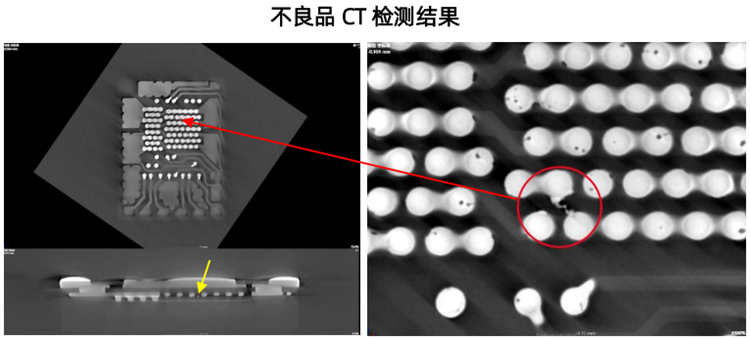
3.4 等离子开封分析
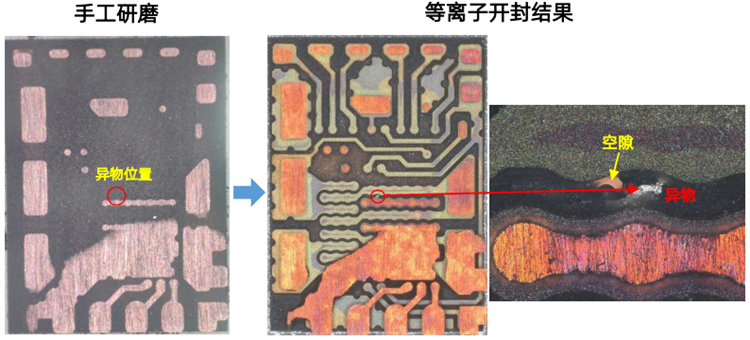
2.芯片内部线路的填料以大小颗粒交叉填充存在,“微短路”位置存在空隙。
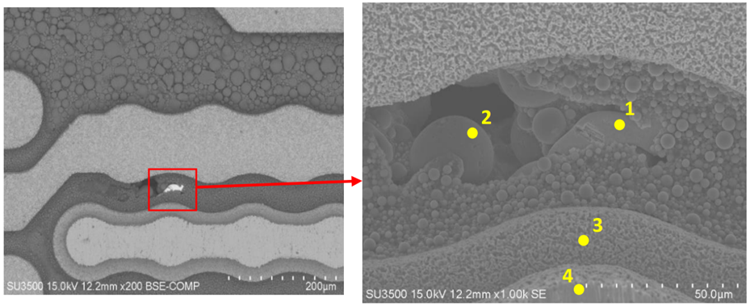
EDS成分分析结果(wt%)

本次分析的不良品芯片采用的封装工艺(见以下参考图):倒装工艺(FlipChip),即在芯片焊盘上形成凸点(通常是焊料、铜柱或金凸点)然后将芯片翻转,使凸点与基板上的对应焊盘对准,通过回流焊或热压合实现电气与机械连接,最后填充底部填充胶以缓解热应力。

2.因金属丝凸起阻碍了底部填充胶的流动,导致树脂填料无法完全填满间隙,形成了未填充空隙。
推荐阅读:

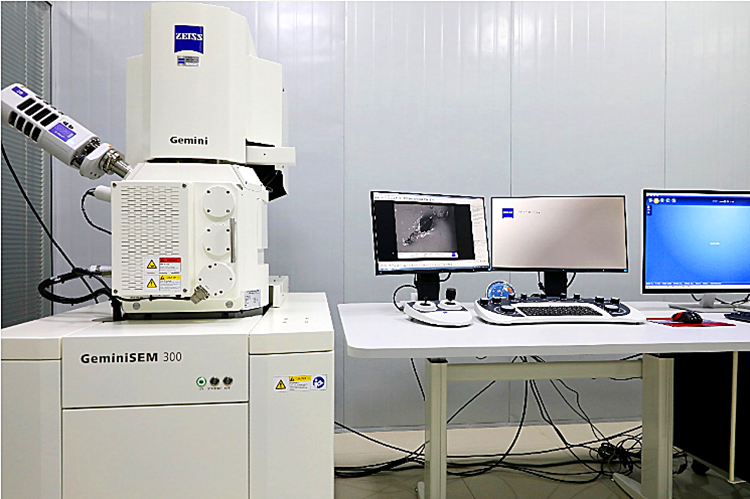 SEM扫描电镜能谱分析技术五大问?
2023-03-04
SEM扫描电镜能谱分析技术五大问?
2023-03-04
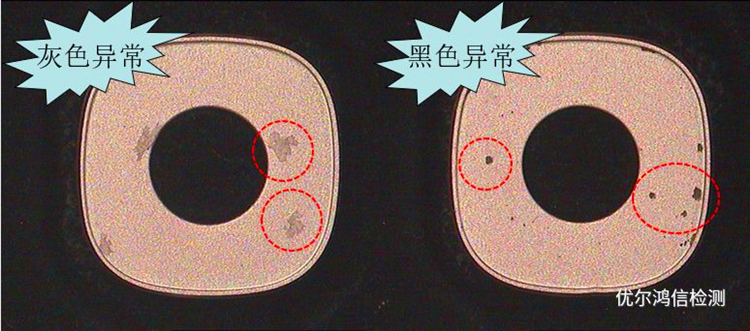 【失效分析】阳极表面异色分析
2023-03-01
【失效分析】阳极表面异色分析
2023-03-01
 清洁度测试与要求
2023-02-25
清洁度测试与要求
2023-02-25
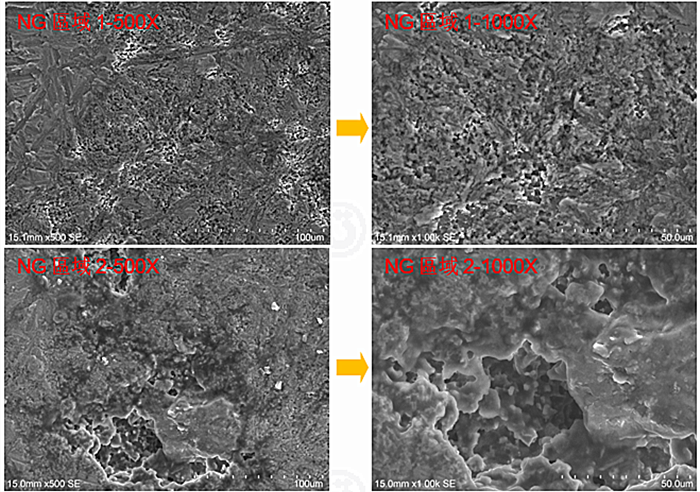 【失效分析】产品DH存在腐蚀斑点失效分析
2023-02-24
【失效分析】产品DH存在腐蚀斑点失效分析
2023-02-24
 【失效分析】汽车应急电源漏电分析
2023-02-04
【失效分析】汽车应急电源漏电分析
2023-02-04